深光谷TGV Interposer技术取得突破
近日,高密度光电集成与光通信技术解决方案提供商深圳光谷科技股份有限公司(SPVTECH)在玻璃通孔光电转接(TGV Interposer)技术上取得重要突破。SPVTECH联合上海交通大学、深圳大学研发出晶圆级TGV光电转接板工艺,实现国内首次8英寸晶圆级TGV转接板加工,实测带宽达到110GHz,可用于2.5D及3D光电集成封装应用,为VCSEL、DML、EML、硅光、铌酸锂等技术路线的光模块产品提供高速、高密度、高可靠、低成本的光电共封装(CPO)解决方案。

基于玻璃的先进封装技术近年来备受关注,在集成无源器件(IPD)、微显示、AR/VR等领域具有突出的应用优势。玻璃具有天然友好的光学特性,激光诱导蚀刻可实现高深宽比玻璃通孔加工,可支持大尺寸晶圆级和面板级加工,其稳定的光电特性还带来高可靠性的优势。2023年9月18日,英特尔推出采用玻璃基板封装的最先进处理器,计划于2026年至2030年量产。基于玻璃基板设计的共封装光学元件技术(CPO)也将在数据中心、人工智能、图形构建等场景带来颠覆性应用。
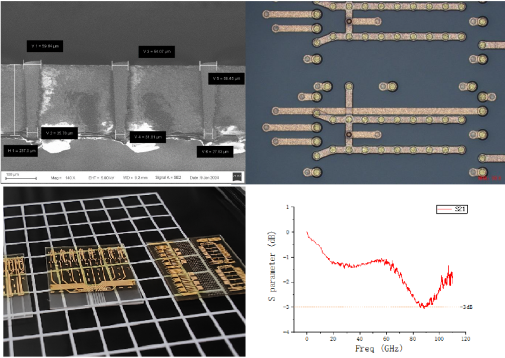
SPVTECH研发的TGV光电中介层采用激光诱导蚀刻结合多层重分布(RDL)技术,通孔深宽比达到4:1,基板厚度230um,表面平整度达到1.2um,支持2+1层RDL,沟槽深度60um,支持光纤阵列耦合配向,支持电芯片倒装封装,支持EML/SOA/硅光/铌酸锂等光芯片倒装贴装,实测通孔及RDL布线带宽超过110GHz。
SPVTECH专注于光传输、光互连的高密度光电集成芯片、光连接器及光纤链路技术。玻璃基光电交换技术(TGV Interposer)将与深圳光岭高密度空分复用技术进一步结合,形成玻璃激光直写光连接器、空分复用技术扇入扇出器件等,发挥全链路高密度优势,支撑在数据中心、计算集群、大容量传输等领域的广泛应用。








